
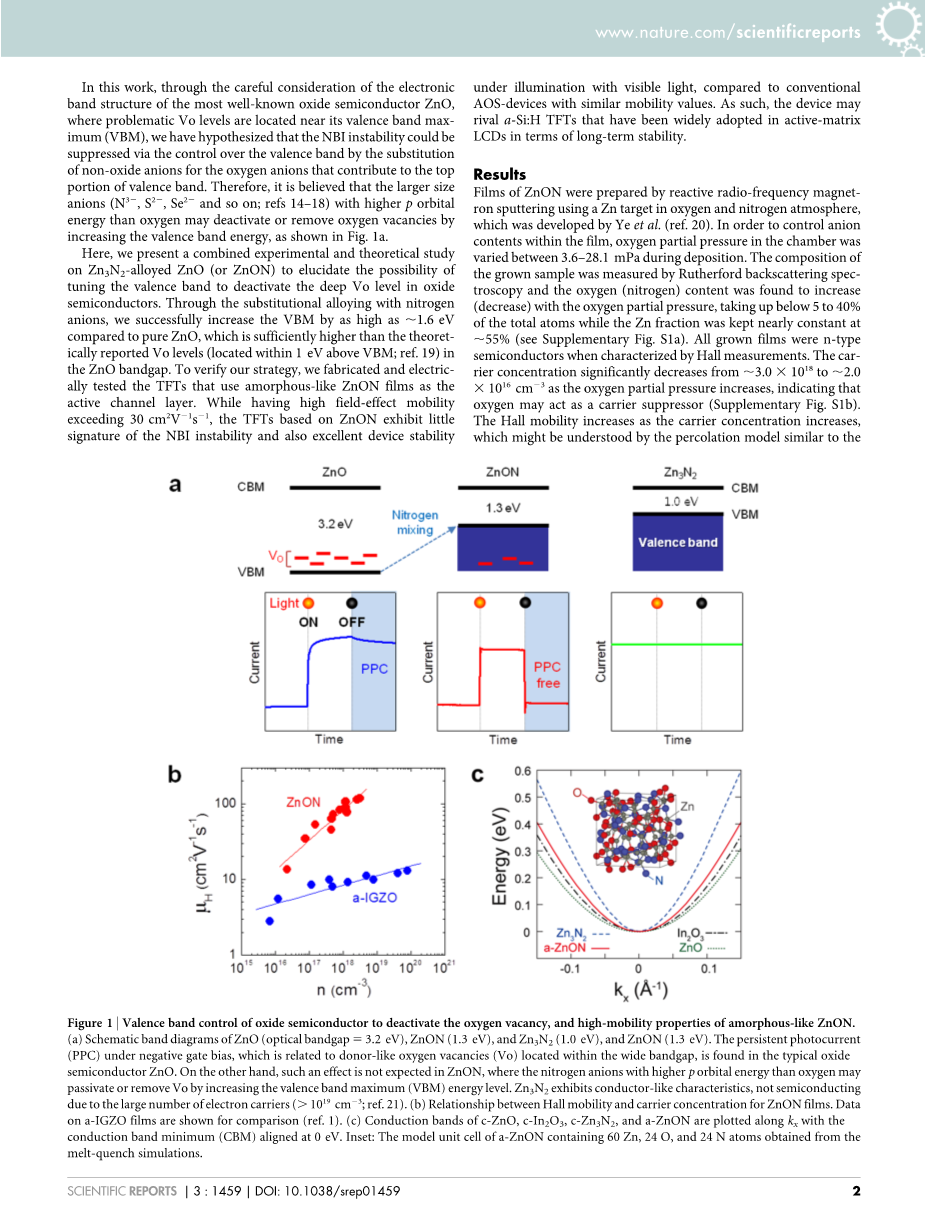
英语原文共 7 页,剩余内容已隐藏,支付完成后下载完整资料
通过负离子控制技术实现薄膜晶体管的高流动性和高稳定性
1韩国京畿道龙仁市446-712,三星电子公司,三星尖端技术研究所,显示设备实验室,
2韩国,首尔151-744,首尔国立大学,材料科学与工程系和先进材料研究所
3韩国,京畿道446-712,龙仁市,三星电子公司,三星电子高级研究所,分析科学小组
0 摘要
超清晰,具有立体视觉效果的大面积显示器代表了当前和未来显示产业的大趋势。在硬件层面,这样的“梦想”显示器需要更快的像素交换和更高的驱动电流,从而需要薄膜晶体管(TFT)具有高迁移率。非晶氧化物半导体(AOS),如非晶铟镓锌氧(In-Ga-Zn-O)正准备被用来实现这样的TFT,但是器件的性能和在光照条件下的稳定性之间的权衡严格限制了非晶氧化物薄膜晶体管的应用,这主要是由于氧空位阻碍了电子-空穴的复合。在这里,我们在ZnO中用氮代替氧来改进光照条件下的稳定性,它是通过将价带提高到缺陷能级之上来抑制氧空位。在光照下的稳定性和电偏压特性的确优于先前的非晶氧化物薄膜晶体管。通过同时实现高迁移率和稳定性,ZnON基TFT将被高度期望会广泛运用在下一代平板显示器中。
1 介绍
薄膜晶体管液晶平板显示器(TFT-LCD)的出现极大地扩展了显示的应用范围,使得大屏幕电视机和各种移动设备的产业化成为可能。 然而,对于更加逼真的视觉体验的需求正在推动学术以及工业研究将超清晰(4000times;2000 pixels),大面积(gt;70英寸)和三维立体效果引入下一代显示器中。无论是采用液晶或有机发光二极管(OLED),这样的高端设备的可行性都依赖于TFT元件的高性能,可以以极快的速度开启或关闭每个像素。从技术层面上说,晶体管的场效应迁移率[1,2]需要高于20cm2 V-1S-1。
由于低制造成本和优异的细胞对细胞均匀性,大多数液晶显示器运用氢化非晶硅(a-Si:H)作为TFT的沟道层。然而,定向的接合从本质上限制了非晶硅的场效应迁移率,这远低于下一代显示器所需。Nomura等人表示非晶体的内在缺陷可通过使用材料的非定向特性在导带内被规避,如非晶铟镓锌氧化物(In-Ga-Zn-O)即所谓的非晶氧化物半导体[3,4](AOS)。一些典型的显示器包括AOS-TFT已被证明有希望实现这一点[2,5]。
然而,研究表明,和高流动性[7,8]同样重要的是,由于在非晶氧化物半导体宽禁带内有类施主的氧空位,当施加光线和负栅极偏压时,就导致了光生电流的慢衰减,并且由于阈值电压的改变而显著危及器件的稳定性。这种负偏置照明(NBI)的不稳定性使得AOS保持导电性几小时或几天,甚至在没有光的情况下。因此,这种缓慢的恢复也限制TFT的开关速度和平板显示器(FPDs)[12]的帧速率。虽然最近已经报道出,通过正短门脉冲的方法使得电子积累并加速重组电离的氧空位,以此来解决负偏置照明的不稳定性,但是这种方法只能被应用到三端器件且偏压方案复杂[12,13]。因此,就需要有一个更基本的解决方案来适应于各种氧化物系统和器件结构。
在这项研究中,经过仔细考虑最为著名的氧化物半导体ZnO的电子价带结构,其中有争议的氧空位能级位于靠近他的价带顶的地方,我们已假设可以通过用非氧化物阴离子来取代价带顶的一部分氧负离子来控制价带以抑制负偏置照明(NBI)的不稳定性。因此,可以相信,较大尺寸的阴离子(N3-,S2-,Se2-)[14-18]比氧有更高的p轨道能量,它可以通过增加价带能量来钝化或者除去氧空位,如图a所示。
图1:价带控制氧化物半导体以抑制氧空位,以及非晶体的高迁移率的特性(如ZnON)
图a:原理能带图,其中光间隙ZnO(3.2eV),ZnON(1.3eV),Zn3N2(1.0eV)。在负栅极偏压下加持续的电流,在氧化物半导体ZnO中可以发现氧空位。而在ZnON中,由于N离子比氧气有更高的p轨道能量,可以通过增加价带顶能级来钝化或者移除氧空位,所以ZnON中没有氧空位的影响。而Zn3N2由于大量的电子载流子,使其展现出类似导体的特性(﹥1019cm-3;参考21)。
图b:表示ZnoN薄膜的霍尔迁移率和载流子浓度之间的关系。a-IGZO薄膜的数据被用来进行比较(参考1)
图c:所绘图像为c-ZnO,c-In2O3,c-Zn3N2,a-ZnON根据Kx的变化曲线,其中导带底对应0eV处。图中的a-ZnON是通过熔融淬火获得,其分子比为Zn:O:N=60:24:24。
在这里,我们提出了一个结合理论和实验的研究,在ZnO(或ZnON)中参杂Zn3N2,以此去证明在氧化物半导体中用调整价带的方法来抑制深能级的氧空位的可能性。与纯的ZnO相比,通过参杂氮阴离子,我们成功地将价带顶(VBM)增加了1.6eV,这已足够高于理论报道中,纯ZnO带隙中的氧空位能级[19](位置在高于价带顶1eV处)。为了验证我们的理论,我们制作出使用非晶体ZnON薄膜作为有效沟道层的TFTs,并对其进行了电测试。当场效应迁移率超过30cm2 V-1S-1时,相比具有相识迁移量的常规非晶体氧化物半导体(AOS)设备,基于ZnON的薄膜晶体管(TFT)在可见光的照射下表现出小幅的NBI不稳定性和良好的器件稳定性。因此,该装置可以媲美的a-Si:H薄膜晶体管,在长期稳定性方面,其已经被广泛应用在有源矩阵液晶显示器中。
2 结果
叶等人已经开发出,在氧气和氮气的环境下,用Zn作为靶材,用射频磁控溅射法制备ZnON薄膜[20]的方法。为了控制薄膜中的阴离子含量,在沉积期间,室内氧分压可在3.6-28.1mPa之间调节。通过卢瑟福背散射光谱法测定了生长样品中的组成,并发现当其中Zn的含量保持在55%不变时,氧(氮)的含量随着氧分压的增加(减少)而增加(减少),并一直占据总原子数的 5%到40%(见补充图S1A)。所有生长成的薄膜以霍尔测量为特点时,薄膜都是n型半导体。当氧分量增加时,载流子浓度从3.0times;1018快速降低至2.0times;1016,这表明氧气对载流子有抑制作用(见补充图S1b)。当载流子浓度增加时,霍尔迁移率也相应增加,这可以被理解为类似于a-IGZO[1]的渗流模型,当载流子浓度ge;1017cm-3,可以获得较高的霍尔迁移率(ge;50 cm2 V -1s-1)。值得注意的是,ZnON的霍尔迁移率随着载流子浓度的增加而增加的速度比a-IGZO更加快速。这可以归因于ZnON是仅由单一Zn2 组成的,它的导带边缘上方有相对低的势垒,而不像在a-IGZO中是由随机分布的多个阳离子(In3 ,Zn2 ,Ga3 )组成的[20]。在所有后续的实验中,在14毫帕下制成的薄膜显示出高的霍尔迁移率数(ge;50 cm2V -1s-1)和合理的低载流子浓度(ge;1017cm-3)。该薄膜的化学组成以原子百分数表示为Zn:N:O=56.3:521.7:22.0。
在掠入射角的X射线衍射(补充图S2a)中,ZnON薄膜被证实能够保持非晶状结构的最大退火温度为350℃,这与TFT制造中的最大工艺温度相同,(即ZnON沉积前栅极绝缘体生长)。据悉,ZnON的非晶形理论是在立方锌的生长与六角形的ZnO溅射法生长两者竞争中得以发展的。透射电子显微镜(TEM)的图像进一步揭示了在非晶体中存在着一小部分随机分散的纳米微晶(补充图S2b)。这种薄膜具有光滑的表面,表面没有明显的晶粒边界且平均只有0.7纳米(补充图S2c)见方的表面粗糙度。在补充图S3中,X射线光电子能谱(XPS)显示了N-Zn和O-Zn带的存在,这证实了氮氧化合物的存在。氧的1s轨道在531.4eV有额外的小峰值,这可能是由于X射线光电子能谱(XPS)分析之前意外吸收的OH杂质。在Ar溅射之前,该特点在顶面采集到的氧1s轨道光谱中更加明显。
图2a的插图显示了在玻璃基板上ZnON和ZnO薄膜图像。相比氧化锌的高度透明,ZnON由于在可见光波长范围内的强吸收而具有相对较暗的颜色(光子能量,hv=1.65-3.18eV)。事实上,利用Tauc模型估算的ZnON光带隙大约是1.3eV,其光带隙能量是从3.2eV的ZnO急剧降低而来并略微高于光带隙为1.0eV的Zn3N2[22,23],这表明ZnON是窄带隙半导体。我们还注意到,ZnO有一个大的Urbach带尾,这表明了大密度禁带缺陷态的存在主要来自于氧空位[12]。图2b显示出了靠近价带顶(VBM)的带隙区域的XPS谱图。ZnON薄膜的VBM能级相对ZnO向上移动了1.6 eV,这接近的其光学带隙差(1.9电子伏特)。
为了解非晶态ZnON的电子结构,将其与常规的氧化物/氮化物半导体相比较,可使用基于密度泛函理论(DFT)的第一性原理来进行计算。非晶结构可通过熔融淬火模拟得到。为防止在熔化阶段形成N2分子,该结构要在2000K的温度下进行融化(计算细节见方法部分)。插图1c用化学计量的形式显示了非晶体ZnON的原子结构为Zn60O24N24 。其中我们可以发现,围绕每个原子的顺序是类似于晶体ZnO(c-ZnO) 或者晶体Zn3N2(c-Zn3N2)。插图1c中比较了当电子传导占主导地位时c-ZnO、c-Zn3N2 、a-ZnON这些材料的导带。为了比较,将不同的材的导带最小值放在一起。虽然在非晶氧化物半导体(AOS)中主要的散射机制并不清楚,但导带底部的有效质量应该是一个在任何机制都很重要的参数。它表明,在公式中 (其中ε,ε0,gamma;作为拟合参数[24]),非晶氧化物半导体(AOS)的导带可以很好地嵌合大量狄拉克粒子的色散关系。从这个色散关系推断出的c-ZnO、c-In2O3、c-Zn3N2 、a-ZnON有效质量分别为0.27、0.22、0.10、0.19me。所以,a-ZnON的有效质量处在c-ZnO和c-Zn3N2之间并小于c-In2O3。所以,a-ZnON的高迁移率可能来源于其较小的有效质量。
图2:ZnON的光学特性和电子结构
图a:Tauc图,(alpha;hnu;)2是光子能量hnu;的函数,nu;表示光子频率。图中显示出ZnON,ZnO薄膜的光学间隙(Eg)分别为1.3eV,3.2eV。ZnON,ZnO样品的图像中,可以直观的看出在间隙减少的部分氮气参入的影响。
图b:ZnO和ZnON薄膜的带隙区域的X射线光电子谱,通过外推直线区域的光谱基线来测定价带偏移。
图c:a-ZnON中计算的总的电子式和投射的Zn,O,N原子。价带顶能级被设定为0eV。
图2c显示了此状态下计算出的总电子密度和a-ZnON投射出的Zn、O、N原子。a-ZnON中带隙的降低主要是取决于价带中的N原子状态,这与图2b中的XPS实验数据一致。
我们已经制造出了典型的AOS-TFT器件结构,即用钼作为其源极和漏极材料的超过100底栅ZnON薄膜晶体管。图3b展示了制作出的ZnON TFT的透射电子显微镜(TEM)横截面图像,其中栅极,绝缘体,通道,蚀刻阻挡,及源极/漏极层定义明确,具有优异的厚度均匀性,这表明不存在其结构层之间相互扩散。图3c和3d举例了测量的输出和传输特性的典型例子。在正栅极源电压(VGS)下,源-漏电流(IDS)随着源-漏电压(VDS)的增加而显著增加,这表明其杂化轨道确实是n型。该源-漏电流电压曲线中,在没有电流的低电压区呈现出明显的夹断并且没有电流拥挤,这表明对薄膜晶体管的操作与标准场效应晶体管理论[25]是一致。图3d的传输曲线显示可以得到一个10-12A级的低截止电流和一组108级的开关电流比。图中阈值电压值(VT)为正值(5.4V),这表明在TFT工作在增强模式。由于栅极漏电流大小比IG低,这就保证了TFT特性不会受栅极漏电流影响。其中计算的场效应迁移率达到饱和的最大值42.6 cm2V -1s-1,其与ZnON薄膜的霍尔迁移率(50 cm2V -1s-1)大致相同。然而,相对的的亚阈值摆动(1.2eV)和电压滞后(0.7eV)表明了在信道-绝缘
剩余内容已隐藏,支付完成后下载完整资料
资料编号:[31262],资料为PDF文档或Word文档,PDF文档可免费转换为Word


